傳統銲線式 (wire-bond) SOT-23封裝的散熱能力不甚佳;覆晶式 (FCOL) SOT-23 封裝因內部結構不同,有較好的散熱能力。本應用須知將比較這兩種封裝技術,且提出關於改進
PCB 佈局以達到最佳散熱性能的一些實用原則。
1. 簡介
因SOT-23 封裝占用的面積小、成本低,因此非常普遍,而兩種接腳形式,6-接腳和8-接腳,使得它們可以廣泛用於各種應用之中,如線性穩壓器
(LDO) 和開關穩壓器。
然而,SOT-23封裝的缺點之一是其散熱能力不佳,這是因為這類封裝都沒有導熱墊 (thermal pad) 。
在JEDEC散熱參考板中,標準銲線式 SOT-23-6 封裝的熱阻值 θJA(從接面到環境的熱阻)約為220〜250
℃ / W;即該封裝的環境溫度約為 55 ℃ 左右、而IC的功耗為0.3W時,接面溫度就會達到最高建議值 125℃。
在實際的 PCB 佈局中,有一些方式可以增加散熱能力,如增加至IC 接腳的走線寬度。然而,這些方式是否有效,仍要取決於
SOT-23 封裝內部的結構。
傳統銲線式 (wire-bond) 封裝和覆晶式 (FCOL) 封裝的散熱方式有很大的不同。透過對這兩種封裝類型的內部結構有更多的了解,就可以產生最佳化的
PCB 佈局。
2. 銲線式 (wire bond) SOT-23-6 的封裝結構
下方圖一顯示銲線式 (wire bond) SOT-23-6封裝的基本結構。
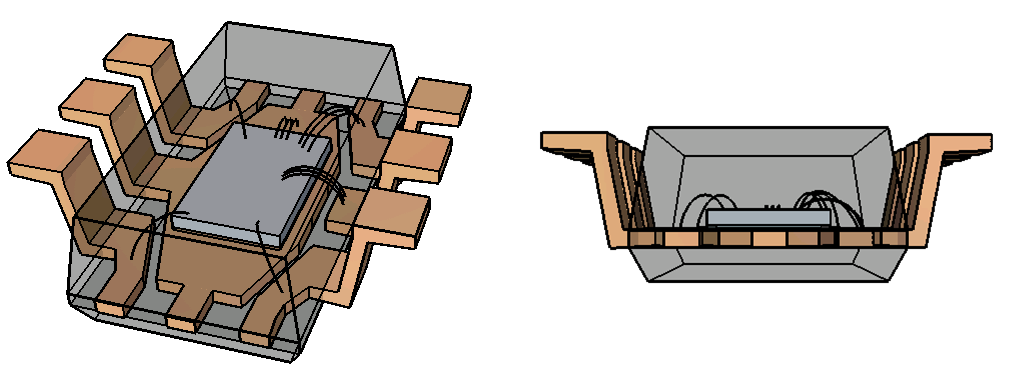
圖一
矽晶粒粘合到中間的接地引線;晶粒的其他電氣連接是經由銲線連至導線架的接腳,其中銲線 (bonding wire)
通常是25-38um金或銅導線。
在重要的電路節點上,這些細銲線會增加電阻、電感和雜散電容,造成高頻開關轉換器的性能降低。特別是在大電流的降壓轉換器,這些銲線對整個元件的總功率損耗影響甚大。
這些細銲線同時也是很差的熱導體,所以無法將大多數產生的熱能從接腳傳遞出去。熱傳導主要是從晶粒的背面、通過粘合劑到中間的接地接腳,因此會在中間接腳上產生熱點。
圖二顯示一個採銲線式SOT-23-6封裝之降壓轉換器的熱影像模擬。該元件的功耗設定為0.5W。

圖二
由上圖可以清楚地看出,中心接腳的溫度明顯比相鄰接腳的溫度要高得多。所有從晶粒到PCB的熱能僅透過此一接腳傳導,所以在此元件中心接腳的周圍會形成一熱點。
3. FCOL SOT-23-6 的封裝結構
下方圖三顯示覆晶式 (FCOL,Flip-Chip-On-Lead) SOT-23-6 封裝的內部結構。(為清楚說明,晶粒以透視圖顯示。)
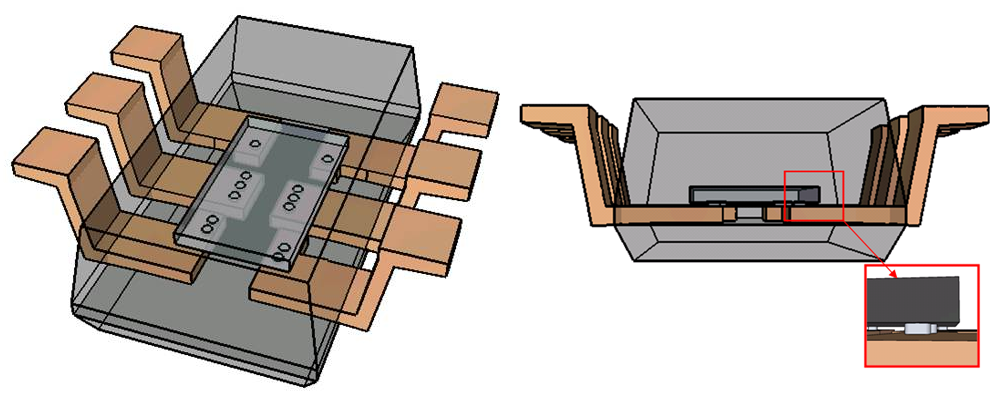
圖三
矽晶粒的正面透過銲柱直接貼著於導線架,使得熱與電可直接由矽晶粒傳至導線架。
銲柱的連線長度非常短,電阻、電感和雜散電容都明顯地降低,所以I2R和開關造成的損耗都因此而降低,同時廢熱也可減少。
所有的接腳現在都如同小散熱片,可達降溫效果,所以有更多的熱從封裝傳到PCB,因此而降低晶粒溫度。圖四顯示了同樣消耗0.5W、在FCOL封裝時,該元件的熱模擬。
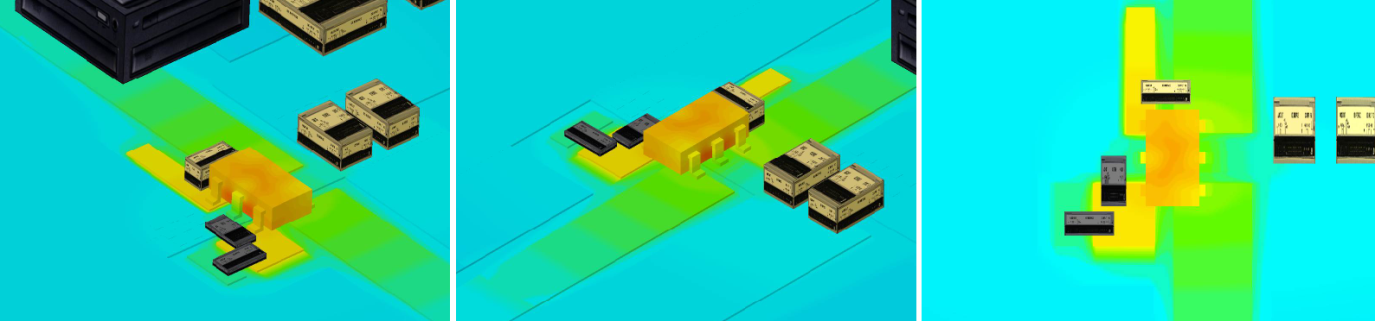
圖四
上述熱模擬清楚地顯示在FCOL封裝時,所有接腳的熱傳導更均勻,且在該元件中間接腳的周圍並無形成熱點。
4. 有關 SOT-23 PCB 佈局的建議
由此可知,銲線式(wire bond) 和覆晶式 (FCOL) SOT-23封裝在元件接腳上的熱傳導特性有很明顯的差異。藉由對此特性的瞭解,PCB佈局工程師可以針對每種封裝來設計並優化
PCB 的佈局。
圖六為一個應用 RT7295CGJ6F 的佈局範例。它是一個採用立錡專有的ACOT® 架構、FCOL
SOT-23封裝、3.5A的降壓轉換器。(型號中的 “F” 代表FCOL)。圖五為其電路示意圖。
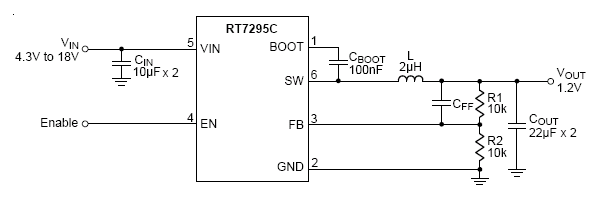
圖五
該降壓轉換器佈局的基本配置如下所示;它採用四層電路板,利用標準通孔連接至內層和底層。
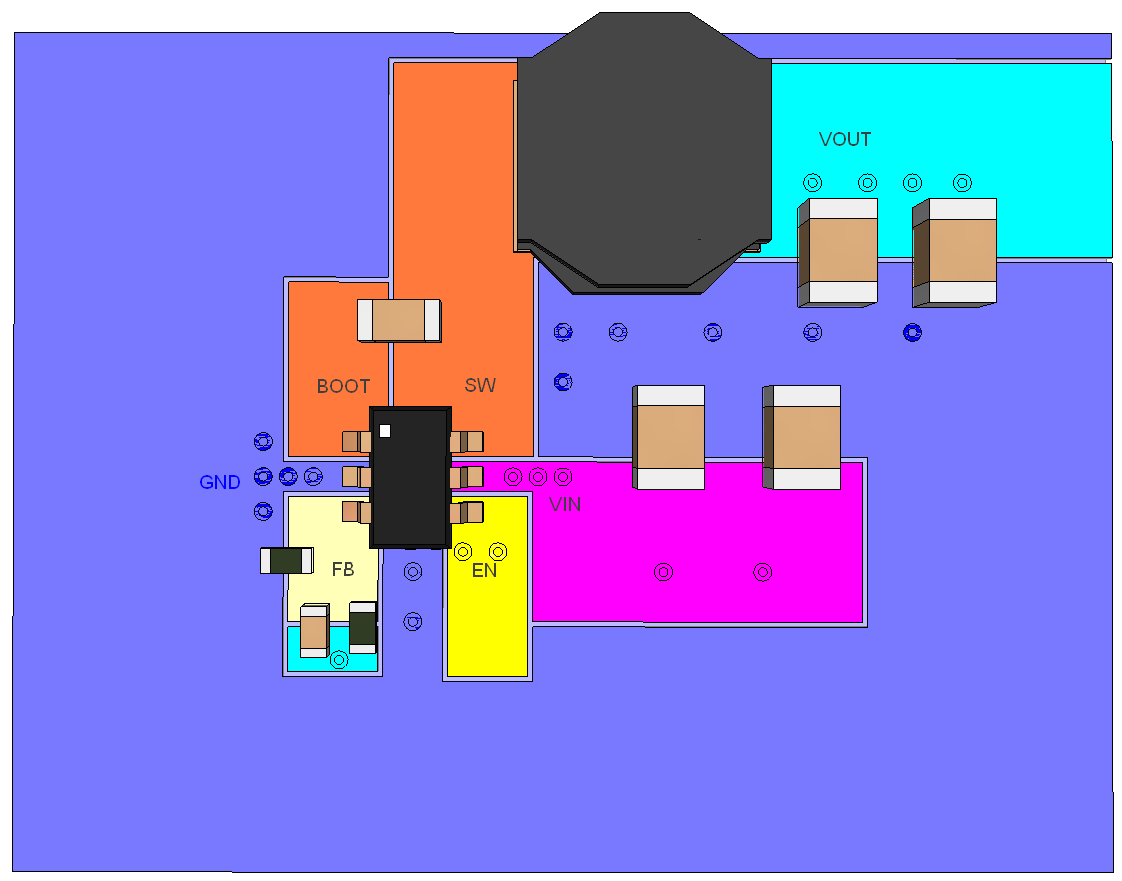
圖六
在圖六的佈局中,每個接腳都增加銅箔面積。然而,對BOOT和SW接腳,銅箔面積變大可能會產生額外的輻射,所以必須採取折衷方式。
FB接腳對雜訊較敏感,所以也不適合用大銅箔面積。 GND和VIN接腳透過幾個通孔連至內層的銅箔面。EN接腳也可以加大銅箔面積,並且連接到底層。

圖七
圖七PCB 板的橫截面按比例顯示它的通孔和內層。通孔通常能有效地將熱從頂層傳導到其它層,所以多加一些通孔有助於熱傳導。
下表顯示不同層的佈局。
|

|

|
|
頂層:在 SW,BOOT (橘色),EN (黃色),FB (米色),VIN (紫色),GND
(藍色) 等的銅箔面。將通孔放在靠近 IC 接腳附近。
|
第二層:接地平面。在IC 的GND 接腳附近多放 GND 通孔 (藍色) 。
|
|

|
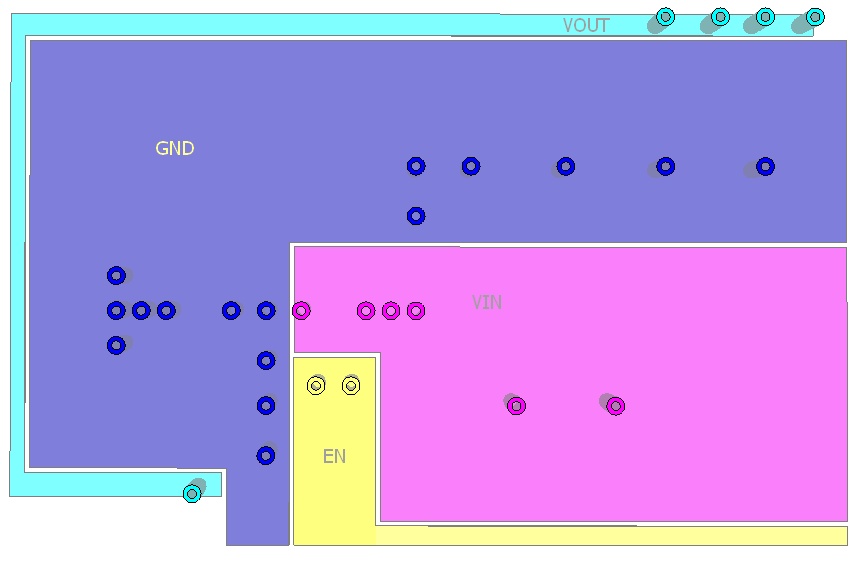
|
|
第三層是電源。多放從 IC VIN 到紫色 VIN 層的通孔。可在此層增加 GND 和
EN 信號的銅箔面。
|
底層有到 EN 的黃色通孔,到 VIN 的紫色通孔和到 GND 的藍色通孔。
|
上方的佈局範例僅供參考。在一些PCB板設計中,頂層和底層空間可能不夠大;在此情況下,透過通孔使IC的接腳與內層的銅箔面連接。而在FCOL封裝中,IC
所有的接腳都可以幫助導熱,所以至PCB銅箔面有好的熱連接,對散熱也會有很大的幫助。
5. 散熱效果量測
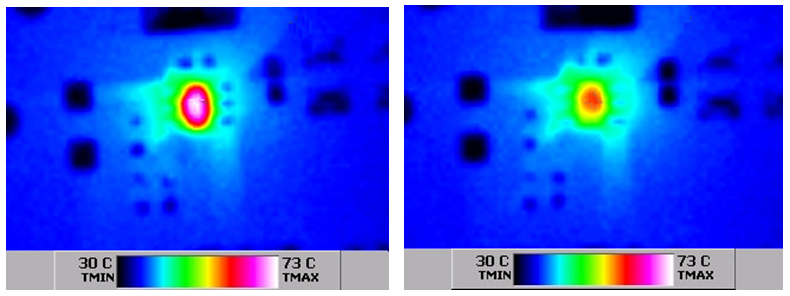
圖八
圖八顯示兩個熱掃描結果:左邊是標準銲線式 (wire-bond) SOT-23-6封裝,而右邊則是覆晶式(FCOL)
SOT-23-6封裝;兩者都被安裝在立錡的評估板,元件消耗功率都是 0.7W,並根據第四章所建議的佈局方式,達到良好的散熱性能。SOT-23-6封裝可見中央有一大熱點,且從熱掃描圖也可看出在封裝左側的接腳較右側的接腳為熱,而這是因為GND接腳位於左側。覆晶式
(FCOL) 封裝的熱點比銲線式的約低了20〜30 ℃;掃描圖也顯示所有接腳有較均勻的熱傳導。
根據上述結果,在一個最佳化的佈局中, FCOL SOT-23-6 封裝從接面至環境的熱阻可以低至 55℃/ W。若在佈局空間有限的情況下,散熱性能可能會差一點,但熱阻值
70〜80℃/ W 是一定可以辦到的。換言之,在 60℃ 的環境溫度下,元件功耗可達到 0.85W。
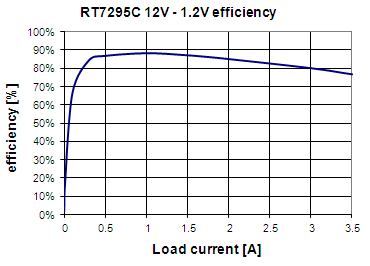
圖九
圖九顯示 RT7295C 於 12V 至 1.2V 應用的效率曲線圖。在負載為 3.1A 時,此 IC的功耗約為
0.85W。這表示當RT7295C用於有加強散熱的 PCB 佈局中時,它可以提供3A的負載電流也不會有過熱現象。
6. 總結
FCOL封裝在電氣與散熱方面都有很好的優點。在FCOL封裝,每個接腳都能為矽晶粒提供良好的熱傳導;且透過適當的PCB佈局,每一個接腳從晶粒到PCB傳導的熱能都更多。如此一來,從接面至環境的總熱阻可以大為降低。和相同外形、而內部是銲線式
(wire-bond) 的封裝相比,覆晶式 (FCOL) 封裝確能提供較好的散熱能力。